请在线提交您的留言,我们将尽快联系您!

作者:YU YAO
SiP技术在20世纪90年代被提出,二十多年来已经被业内接受并蓬勃发展,在未来可预期时间内依然具有较大的发展空间。SiP方案是一个系统集成的工程问题,由于多芯片的整合,在设计上必须考虑电学、热学和机械力学等方面,作出可靠性更高的设计,选择合适的材料和最佳的工艺,另外还要考虑周期、成本、供应链和风险的控制等因素。由于产品的应用和需求不同,SiP设计制造并没有固定模式,各厂商都有自己的一套流程,不同产品流程也会有所差异。初期的SiP主要是将多芯片在二维平面作分布结构设计,通过载板实现集成,虽然实现了SiP的定义,但是在体积、运行效率和功耗等技术指标上还是相对无法满足消费市场上的高端电子产品的需要。随着芯片封装技术的不断发展,部分芯片由二维平面分布排列的方式走向三维堆叠的方式,这是目前较为先进的SiP方式,我们可以称之为2.5D SiP工艺。可以预料,多芯片的3D叠加SiP技术将进一步缩短互连互通的线路距离,进一步提高集成度等,这也是最终3D SiP的发展目标。
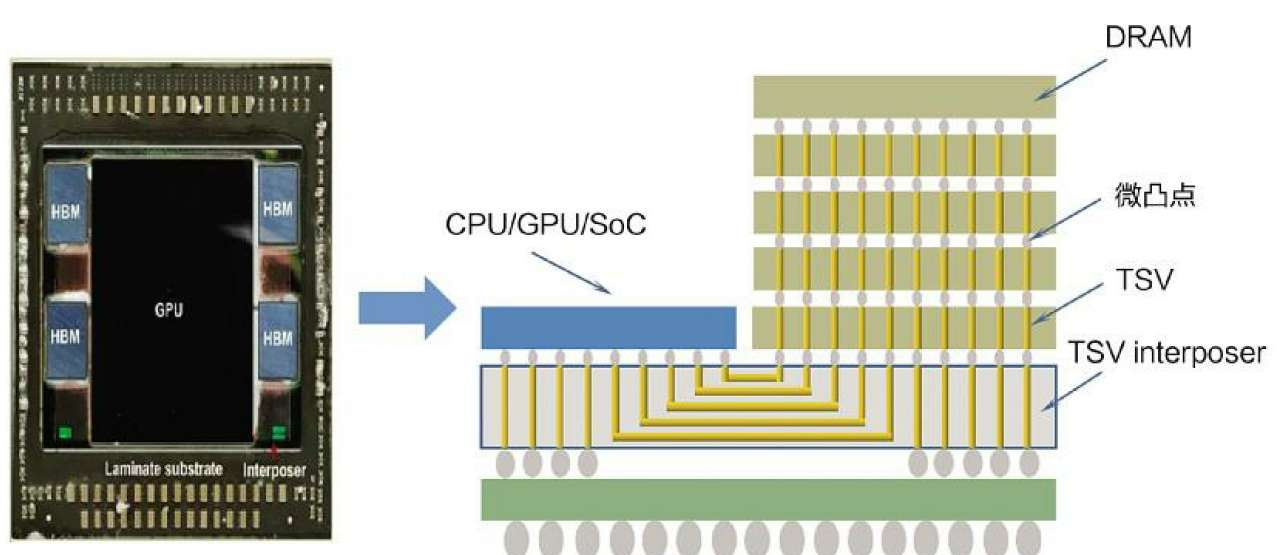
2.5D 封装工艺示意图
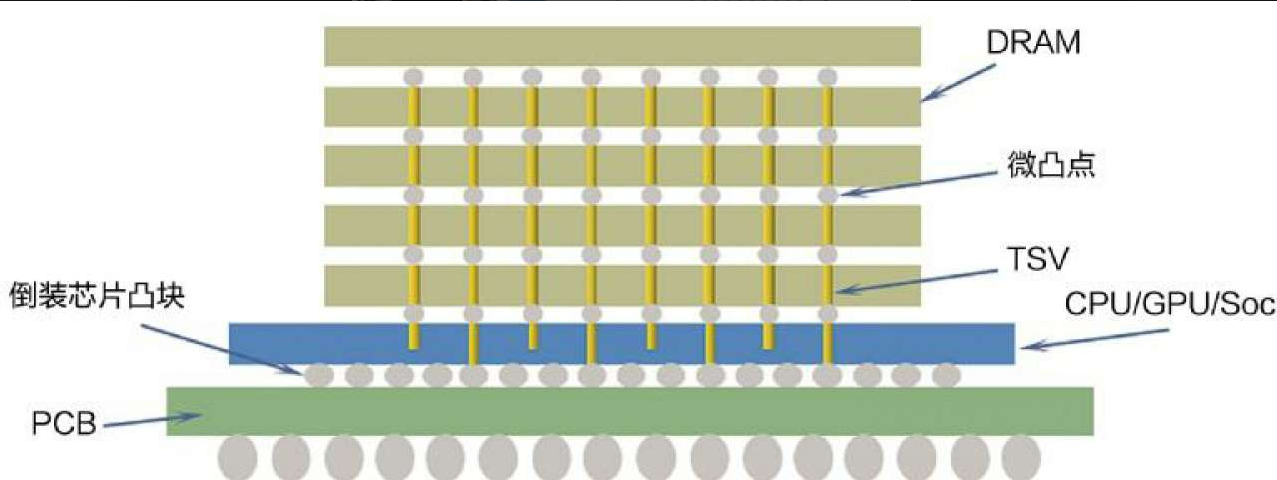
3D 封装工艺示意图
对比以上两图可以了解2.5D和3D封装的区别。3D封装将CPU/GPU/SoC与DRAM堆叠并在垂直方向上连接整合,封装的面积比2.5D封装工艺更小,并且在2.5D封装的基础上还去掉了TSV interposer的部分。
如果您对这篇文章感兴趣,请立即联系我们
请在线提交您的留言,我们将尽快联系您!