请在线提交您的留言,我们将尽快联系您!

作者:
随着消费性电子产品对可携式及多功能要求的日益严格,整合更多功能、提升产品效能、终薄型化以及降低制造商整体成本逐渐成为终端产品及行业厂商智能化的发展方向。
然而,随着摩尔定律极限的逼近,半导体封装产业已经面临无法在微缩芯片的尺寸来提升电子产品效能的窘境。
因此,纵观封装技术的发展历程,从金属导线架到打线封装、覆晶封装(FCBGA)再到扇入型封装(Fan-in-Packaging)以及扇出型封装(Fan-out-Packaging)等先进的封装技术,可以看出其技术升级的趋势在于可以容纳更多的I/O数、减小芯片尺寸和厚度、整合更多异质芯片以达到封装小型化的需求,同时有效降低生产成本,最终应用于消费性、高速运算和专业性电子产品等应用。
据行业现状可以看到,目前的主流封装技术仍以打线封装为主,但随着5G、IOT等新兴技术的发展趋势以及消费类电子产品的薄型化要求,倒装封装(Flip chip)的比例正在逐渐提高。
相比倒装封装技术,扇出型封装表面积更小、没有基板与中介层,降低厚度、管脚数密度增加、较低的热阻抗、更好的电气性能以及更高潜力的系统级封装及3D整合能力,能够更好满足终端市场对产品效能和体积的需求。
封装产业积极投入扇出型封装技术,藉由重布线路层把不同功能的芯片与被动组件连接在一起,降低封装的体积,或是透过新型垂直整合方式的三维集成电路(3D IC),都是经由改变芯片在系统中组装组装和互联的方式,同时兼顾成本以及性能,将异质芯片整合在单一封装内。
扇出型封装技术分为扇出型晶圆级封装(FOWLP)和扇出型面板级封装(FOPLP)两种类型,两者虽然技术路线及应用不同,但都可以让产品达到更轻薄的外型。FOPLP与FOWLP相比,成本优势使其成为近年备受关注的原因。FOPLP的技术研发提升了芯片效能及散热性,同时达到芯片小型化及降低成本的市场需求。目前,FOPLP分为采用FPD制程设备为基础和采用PCB载板制程为基础的两大技术。

扇出型晶圆级封装 VS 扇出型面板级封装
从下图可以看到:封装行业的商业模式演变及市场销售额走向朝着Foundry和IDM倾斜,扇出型封装将逐渐成为重要角色。

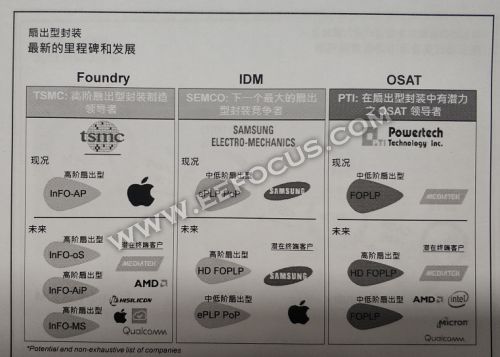
数据来源:Yole Developpement
其中,扇出型封装现阶段格局为:以Foundry厂商台积电为代表的高阶扇出型封装、IDM厂三星电机为代表的中低级扇出型封装和以OSAT厂力成为代表的中低阶扇出型封装。但是其未来演进趋势都是朝着高阶扇出型封装为走向。
其市值演变预测如下:

数据来源:Yole Developpement
此外,对于扇出型面板级封装的研发动机,蔡承祐认为,扇出型封装从晶圆演变到面板,成本、市场趋势、技术、应用领域和战略行动都是公司动力所在,以成本优势切入扇出型封装技术、利用FPD/PCB/PV专业知识的经验创造新的商业模式、高密度、低成本的扇出型面板级封装解决方案,以走向高阶应用市场。
免责声明|部分素材源自L晨光 与非网eefocus,转载仅作为行业分享交流,不代表本司观点,版权归原作者所有。如涉侵权,请联系我们处理。另外,如若转载本文,请标明出处。
如果您对这篇文章感兴趣,请立即联系我们
请在线提交您的留言,我们将尽快联系您!