请在线提交您的留言,我们将尽快联系您!

作者:知乎:石大小生
晶圆级封装(Wafer Level Packaging,缩写WLP)是一种先进的封装技术,因其具有尺寸小、电性能优良、散热好、成本低等优势,近年来发展迅速。
不同于传统封装工艺,晶圆级封装是在芯片还在晶圆上的时候就对芯片进行封装,保护层可以黏接在晶圆的顶部或底部,然后连接电路,再将晶圆切成单个芯片。
WLP的优势:
晶圆级封装(WLP)就是在封装过程中大部分工艺过程都是对晶圆(大圆片)进行操作,对晶圆级封装(WLP)的需求不仅受到更小封装尺寸和高度的要求,还必须满足简化供应链和降低总体成本,并提高整体性能的要求。
晶圆级封装提供了倒装芯片这一具有极大优势的技术,倒装芯片中芯片面朝下对着印刷电路板(PCB),可以实现最短的电路径,这也保证了更高的速度,降低成本是晶圆级封装的另一个推动力量。
器件采用批量封装,整个晶圆能够实现一次全部封装。在给定晶片上封装器件的成本不会随着每片晶片的裸片数量而改变,因为所有工艺都是用掩模工艺进行的加成和减法的步骤。
WLP技术的两种类型:
总体来说,WLP技术有两种类型:“扇入式”(fan-in)和“扇出式”(fan-out)晶圆级封装。
传统扇入WLP在晶圆未切割时就已经形成。在裸片上,最终的封装器件的二维平面尺寸与芯片本身尺寸相同。器件完全封装后可以实现器件的单一化分离(singulation)。
因此,扇入式WLP是一种独特的封装形式,并具有真正裸片尺寸的显著特点。具有扇入设计的WLP通常用于低输入/输出(I/O)数量(一般小于400)和较小裸片尺寸的工艺当中。
另一方面,随着封装技术的发展,逐渐出现了扇出式WLP。扇出WLP初始用于将独立的裸片重新组装或重新配置到晶圆工艺中,并以此为基础,通过批量处理、构建和金属化结构,如传统的扇入式WLP后端处理,以形成最终封装。
扇出式WLP可根据工艺过程分为芯片先上(Die First)和芯片后上(Die Last),芯片先上工艺,简单地说就是先把芯片放上,再做布线(RDL),芯片后上就是先做布线,测试合格的单元再把芯片放上去,芯片后上工艺的优点就是可以提高合格芯片的利用率以提高成品率,但工艺相对复杂。
eWLB就是典型的芯片先上的Fan out工艺,长电科技星科金朋的Fan-out,安靠(Amkor)的葡萄牙工厂均采用的芯片先上的工艺。TSMC的INFO也是芯片先上的Fan-out产品。安靠和ASE也都有自己成熟的芯片后上的Fan-out工艺。
在电子设备的发展历史中,WLP封装技术的推广产生了很多全新的产品。
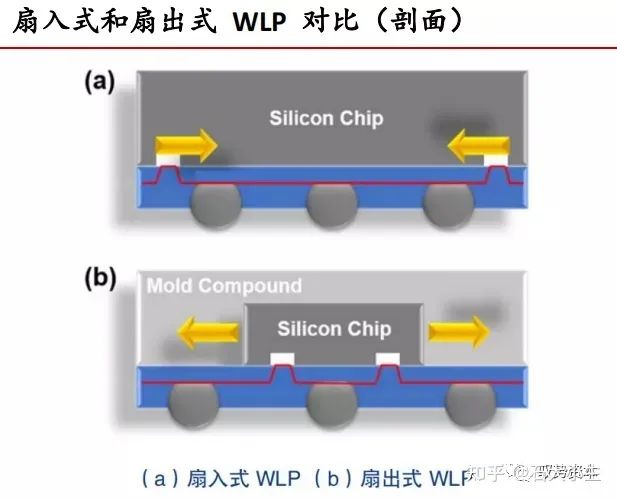
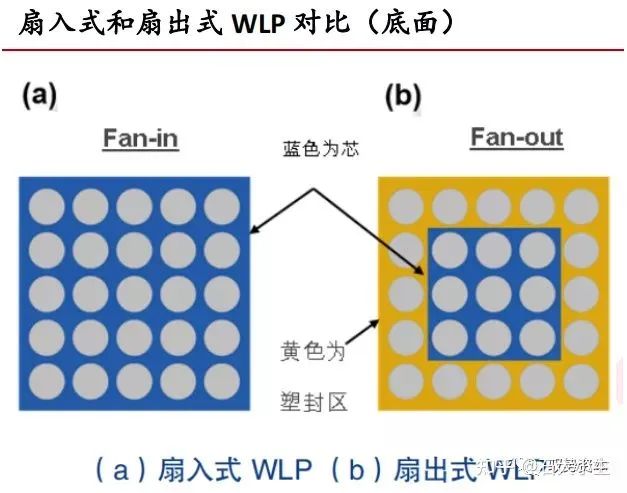
例如得益于WLP的使用,摩托罗拉能够推出其RAZR手机,该手机也是其推出时最薄的手机。最新型号的iPhone采用了超过50颗WLP,智能手机是WLP发展的最大推动力。
随着金线价格的上涨,一些公司也正在考虑采用WLP作为低成本替代方案,而不是采用引线键合封装,尤其是针对更高引脚数的器件。最近几年中,WLP也已经被广泛用于图像传感器的应用中。目前,硅通孔(TSV)技术已被纳入用于封装图像传感器的WLP解决方案。其他更新的封装技术也在逐渐发展,并与现有的WLP技术进行整合,例如三维(3D)集成技术。
如果您对这篇文章感兴趣,请立即联系我们
请在线提交您的留言,我们将尽快联系您!